Crossref Citations
This article has been cited by the following publications. This list is generated based on data provided by
Crossref.
Glavin, Nicholas R.
Chabak, Kelson D.
Heller, Eric R.
Moore, Elizabeth A.
Prusnick, Timothy A.
Maruyama, Benji
Walker, Dennis E.
Dorsey, Donald L.
Paduano, Qing
and
Snure, Michael
2017.
Flexible Gallium Nitride for High‐Performance, Strainable Radio‐Frequency Devices.
Advanced Materials,
Vol. 29,
Issue. 47,
Wang, Baoming
Wang, Tun
Haque, Aman
Snure, Michael
Heller, Eric
and
Glavin, Nicholas
2017.
In-situ TEM study of domain switching in GaN thin films.
Applied Physics Letters,
Vol. 111,
Issue. 11,
Snure, Michael
Siegel, Gene
Look, David C.
and
Paduano, Qing
2017.
GaN and AlGaN/GaN heterostructures grown on two dimensional BN templates.
Journal of Crystal Growth,
Vol. 464,
Issue. ,
p.
168.
Wu, Qingqing
Yan, Jianchang
Zhang, Liang
Chen, Xiang
Wei, Tongbo
Li, Yang
Liu, Zhiqiang
Wei, Xuecheng
Zhang, Yun
Wang, Junxi
and
Li, Jinmin
2017.
Growth mechanism of AlN on hexagonal BN/sapphire substrate by metal–organic chemical vapor deposition.
CrystEngComm,
Vol. 19,
Issue. 39,
p.
5849.
Wang, Tun
Wang, Baoming
Haque, Aman
Snure, Michael
Heller, Eric
and
Glavin, Nicholas
2018.
Mechanical stress effects on electrical breakdown of freestanding GaN thin films.
Microelectronics Reliability,
Vol. 81,
Issue. ,
p.
181.
Blanton, Eric W.
Siegel, Gene
Prusnick, Timothy A.
Glavin, Nicholas R.
and
Snure, Michael
2018.
Strain-induced changes in AlGaN/GaN two-dimensional electron gas structures with low surface state densities.
Applied Physics Letters,
Vol. 113,
Issue. 26,
Wu, Qingqing
Guo, Yanan
Sundaram, Suresh
Yan, Jianchang
Zhang, Liang
Wei, Tongbo
Wei, Xuecheng
Wang, Junxi
Ougazzaden, Abdallah
and
Li, Jinmin
2019.
Exfoliation of AlN film using two-dimensional multilayer hexagonal BN for deep-ultraviolet light-emitting diodes.
Applied Physics Express,
Vol. 12,
Issue. 1,
p.
015505.
Mancini, L
Morassi, M
Sinito, C
Brandt, O
Geelhaar, L
Song, Hyun-Gyu
Cho, Yong-Hoon
Guan, N
Cavanna, A
Njeim, J
Madouri, A
Barbier, C
Largeau, L
Babichev, A
Julien, F H
Travers, L
Oehler, F
Gogneau, N
Harmand, J-C
and
Tchernycheva, M
2019.
Optical properties of GaN nanowires grown on chemical vapor deposited-graphene.
Nanotechnology,
Vol. 30,
Issue. 21,
p.
214005.
Zhang, Baoguo
Wu, Yongzhong
Zhang, Lei
Huo, Qin
Hu, Haixiao
Ma, Fukun
Yang, Mingzhi
Shi, Dong
Shao, Yongliang
and
Hao, Xiaopeng
2019.
Growth of high-quality GaN crystals on a BCN nanosheet-coated substrate by hydride vapor phase epitaxy.
CrystEngComm,
Vol. 21,
Issue. 8,
p.
1302.
Kum, Hyun
Lee, Doeon
Kong, Wei
Kim, Hyunseok
Park, Yongmo
Kim, Yunjo
Baek, Yongmin
Bae, Sang-Hoon
Lee, Kyusang
and
Kim, Jeehwan
2019.
Epitaxial growth and layer-transfer techniques for heterogeneous integration of materials for electronic and photonic devices.
Nature Electronics,
Vol. 2,
Issue. 10,
p.
439.
Liu, F.
Rong, X.
Yu, Y.
Wang, T.
Sheng, B. W.
Wei, J. Q.
Liu, S. F.
Yang, J. J.
Bertram, F.
Xu, F. J.
Yang, X. L.
Zhang, Z. H.
Qin, Z. X.
Zhang, Y. T.
Shen, B.
and
Wang, X. Q.
2020.
Thermally annealed wafer-scale h-BN films grown on sapphire substrate by molecular beam epitaxy.
Applied Physics Letters,
Vol. 116,
Issue. 14,
Motala, Michael J.
Blanton, Eric W.
Hilton, Albert
Heller, Eric
Muratore, Christopher
Burzynski, Katherine
Brown, Jeff L.
Chabak, Kelson
Durstock, Michael
Snure, Michael
and
Glavin, Nicholas R.
2020.
Transferrable AlGaN/GaN High-Electron Mobility Transistors to Arbitrary Substrates via a Two-Dimensional Boron Nitride Release Layer.
ACS Applied Materials & Interfaces,
Vol. 12,
Issue. 19,
p.
21837.
Wu, Jinxing
Li, Peixian
Xu, Shengrui
Zhou, Xiaowei
Tao, Hongchang
Yue, Wenkai
Wang, Yanli
Wu, Jiangtao
Zhang, Yachao
and
Hao, Yue
2020.
Epitaxial Growth of GaN on Magnetron Sputtered AlN/Hexagonal BN/Sapphire Substrates.
Materials,
Vol. 13,
Issue. 22,
p.
5118.
Glavin, Nicholas R
Muratore, Christopher
and
Snure, Michael
2020.
Toward 2D materials for flexible electronics: opportunities and outlook.
Oxford Open Materials Science,
Vol. 1,
Issue. 1,
Chugh, Dipankar
Adhikari, Sonachand
Wong-Leung, Jennifer
Lysevych, Mykhaylo
Jagadish, Chennupati
and
Tan, Hark Hoe
2020.
Improving the Morphology and Crystal Quality of AlN Grown on Two-Dimensional hBN.
Crystal Growth & Design,
Vol. 20,
Issue. 3,
p.
1811.
Paquette, Michelle M.
Caruso, Anthony N.
Brockman, Justin
Bielefeld, Jeff
Kuhn, Markus
and
King, Sean W.
2020.
Band offsets at amorphous hydrogenated boron nitride/high-k oxide interfaces from x-ray photoelectron spectroscopy with charging effects analysis.
Journal of Vacuum Science & Technology B, Nanotechnology and Microelectronics: Materials, Processing, Measurement, and Phenomena,
Vol. 38,
Issue. 3,
Liang, Dongdong
Wei, Tongbo
Wang, Junxi
and
Li, Jinmin
2020.
Quasi van der Waals epitaxy nitride materials and devices on two dimension materials.
Nano Energy,
Vol. 69,
Issue. ,
p.
104463.
Burzynski, Katherine M.
Glavin, Nicholas R.
Snure, Michael
Motala, Michael J.
Ferguson, John
Blanton, Eric
Heckman, Emily
and
Muratore, Christopher
2021.
Graphite Nanocomposite Substrates for Improved Performance of Flexible, High-Power AlGaN/GaN Electronic Devices.
ACS Applied Electronic Materials,
Vol. 3,
Issue. 3,
p.
1228.
Blanton, Eric W.
Motala, Michael J.
Prusnick, Timothy A.
Hilton, Albert
Brown, Jeff L.
Bhattacharyya, Arkka
Krishnamoorthy, Sriram
Leedy, Kevin
Glavin, Nicholas R.
and
Snure, Michael
2021.
Spalling‐Induced Liftoff and Transfer of Electronic Films Using a van der Waals Release Layer.
Small,
Vol. 17,
Issue. 42,
Kim, Hyunseok
Kong, Wei
and
Kim, Jeehwan
2021.
Micro Light Emitting Diode: Fabrication and Devices.
p.
87.
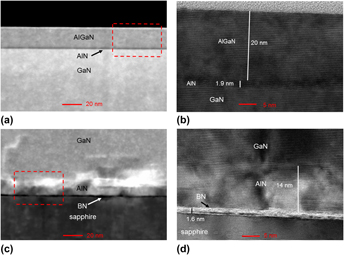
 $10\bar 12$
) diffraction peaks. Hall-effect measurements show room temperature mobility near 2000 cm/V·s with sheet carrier density of ∼1 × 1013 cm−2, comparable to the best values obtained on sapphire using Fe-doped GaN buffers. The best low temperature mobility of the 2-dimensional electron gas (2DEG) is ∼33,000 cm2/V·s; indicating that the dominant scattering mechanism limiting the transport of 2DEG is interface roughness. Good quality BN grown directly onto sapphire is shown to be effective for reducing parallel conduction that exists due to residual donor impurities in the buffer. Luminescence measurements indicate good optical quality of the GaN/BN/sapphire. The residual strain in the GaN layer is found to be almost completely eliminated when it is released from the substrate.
$10\bar 12$
) diffraction peaks. Hall-effect measurements show room temperature mobility near 2000 cm/V·s with sheet carrier density of ∼1 × 1013 cm−2, comparable to the best values obtained on sapphire using Fe-doped GaN buffers. The best low temperature mobility of the 2-dimensional electron gas (2DEG) is ∼33,000 cm2/V·s; indicating that the dominant scattering mechanism limiting the transport of 2DEG is interface roughness. Good quality BN grown directly onto sapphire is shown to be effective for reducing parallel conduction that exists due to residual donor impurities in the buffer. Luminescence measurements indicate good optical quality of the GaN/BN/sapphire. The residual strain in the GaN layer is found to be almost completely eliminated when it is released from the substrate.




